Evolution der Struktur in dünnen Schichten
Das Wachstum dünner polykristalliner Schichten ist oft mit einer bevorzugten Orientierung der Kristallite verbunden, bei der bestimmte kristallographische Richtungen der Körner (hkl) bevorzugt parallel zur Substratnormalen n orientiert sind. Das Phänomen ist seit langem bekannt und wird Schichttextur oder Fasertextur genannt. Die Rotationssymmetrie der Orientierungsverteilungsfunktion (ODF) ergibt sich einfach aus der Abscheidegeometrie, wenn n die einzige überhöhte Richtung ist.
Die gründliche Untersuchung von Texturen kann Details über die Mechanismen des Schichtwachstums aufdecken und ist heute ein stark untersuchtes Feld in der Dünnschichtforschung. Es wird erwartet, dass durch die Kontrolle der kristallinen Orientierung dünne Schichten mit optimierten Eigenschaften hergestellt werden können, was zum Beispiel für Hoch-Tc-Supraleiter, halbleitende Si-Schichten, harte und abriebfeste Nitridbeschichtungen, transparente leitfähige Oxide, wie sie in Solarzellen, Flachbildschirme und organischen Leuchtdioden verwendet werden, von großem Interesse ist.
In Bezug auf die physikalischen Prinzipien, die die bevorzugte Orientierungen in dünnen Schichten bestimmen, muss man zunächst die Oberflächenenergie der niedrig indizierten kristallographischen Gitterebenen betrachten. Gitterebenen mit hohen Atomdichten und niedriger Oberflächenenergie werden im Allgemeinen bevorzugt. Außerdem wurde oft festgestellt, dass die bevorzugten Orientierungen mit zunehmender Schichtdicke zunehmen, was vermutlich auf eine Korn-zu-Korn-Epitaxie zurückzuführen ist. Darüber hinaus kann die Textur bei CVD-Prozessen durch die Wahl der Precursoren oder bei plasmaunterstützten PVD-Prozessen durch den Ionenbeschuss während des Wachstums gesteuert werden. In-situ-Untersuchungen des Dünnschichtwachstums zeigten die wichtige Rolle der mechanischen Spannungen innerhalb der Schicht, die die Entwicklung der Textur stark beeinflussen.
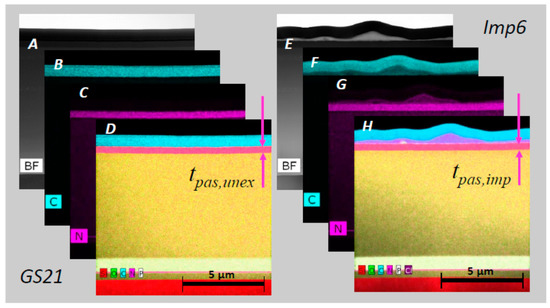
Untersuchungen zur Textur/Vorzugsorientierung wruden mit Kollegen vom Hahn-Meitner Institut Berlin durchgeführt und bezogen sich auf
- dünne Si-Schichten, die durch verschiedene Techniken wie plasmaunterstützte CVD [28, 31, 32, 33], Magnetronsputtern [35] und Al-induzierte Kristallisation [27] hergestellt wurden, Al-dotierte ZnO-Schichten für transparent-leitende Elektrodenanwendungen [37, 41, 46, 49] und reine metallische Ti-Filme für Haftschichtanwendungen [40].
- Al-doped ZnO films for transparent-conductive electrode applications [37, 41, 46, 47] and
- pure metallic Ti films for adhesion layer applications [40].
Im Laufe dieser Forschungsarbeiten wurden eine allgemeine und analytische Beschreibung für die Diffraktogramme von Fasertexturgradienten ausgearbeitet [46] und auf den Spezialfall der anomalen Röntgenbeugung von dünnen ZnO:Al Schichten angewandt [47].
In polykristallinen Si-Schichten für elektronische Anwendungen in Solarzellen-Absorptionsschichten, Dünnschichttransistoren etc. ist die relative Orientierung benachbarter Körner ein sehr relevantes Thema, da die Streuung der Ladungsträger empfindlich von der Korngrenze abhängt. Großwinklige Korngrenzen wirken sich nachteilig auf die Ladungsträgerbeweglichkeit aus und sollten auf eine möglichst geringe Konzentration reduziert werden.
Texturuntersuchungen an dünnen Schichten können mit Röntgenbeugungsmethoden (XRD) durchgeführt werden. Wie bei der klassischen Texturanalyse von Volumenmaterialien muss eine Reihe von Polfiguren gemessen werden, die Bragg-Peak-Intensitätsverläufe als Funktion des Drehwinkels phi und des Kippwinkels psi darstellen. Speziell bei Fasertexturen kann die phi-Abhängigkeit vernachlässigt werden, was den Auswerteprozess erheblich vereinfacht. Ein wichtiger Punkt bei der XRD-Analyse von Dünnschichten ist ein ausreichend hohes Signal-Rausch-Verhältnis während der Messung. Da die Eindringtiefe der Röntgenstrahlung, die mit dem inversen linearen Absorptionskoeffizienten µ skaliert, oft viel größer ist als die Schichtdicke t, 1/µ >> t, stammt nur ein kleiner Anteil der vom Detektor empfangenen Beugungsintensität aus der Schicht. Das Problem kann durch die Verwendung neuer hochempfindlicher Detektoren, wie in [37] geschehen, oder durch die Durchführung der Messung an Synchrotronstrahlungslinien verringert werden, wo Röntgenstrahlung hoher Intensität routinemäßig verfügbar ist.
From the pole figure data the orientation distribution function (ODF) is calculated and the volume fraction of crystallite orientation may be determined. The ODF is the decisive quantity to account for the structure-function relationship in polycrystalline thin films. The texture analysis can also be used to optimise the sharpness of texture by recursively introducing the results into the deposition process [41,47].
[Die Zahlen in eckigen Klammern] stehen immer für die Nummern in der Publikationsliste